在过去三到四年期间,美国Alcatel公司(Richardson, TX)已经在作消除对尽可能多的混合技术PCB的波峰焊接需要的工作。减少波峰焊接的计划已经提供了成本与周期时间的重要改善。
通孔回流焊接工艺的实施已经是该计划的一个必要部分。该工艺涉及在通孔(through-hole)元件要插位置印刷锡膏。这些元件然后在表面回流焊接炉之前安装,并与其它元件一起焊接。适合该工艺的元件类型包括针栅阵列(PGA, pin grid array)、DIP(dual in-line package)和各种连接器。
初始结果
能力分析(capability studies) Alcatel公司的工艺质量标准对所有通孔元件一直要求至少75%的通孔填充。焊接工业标准 J-STD-001 B1 (第三类应用)要求垂直填充至少75%,并明显有良好的熔湿。计算显示,假设将孔的尺寸从波峰焊接和手工焊接正常使用的减少,0.007"的模板可提供足够的焊锡满足这些要求。
Alcatel公司的工艺质量标准对所有通孔元件一直要求至少75%的通孔填充。焊接工业标准 J-STD-001 B1 (第三类应用)要求垂直填充至少75%,并明显有良好的熔湿。计算显示,假设将孔的尺寸从波峰焊接和手工焊接正常使用的减少,0.007"的模板可提供足够的焊锡满足这些要求。
通过使用一种为新工艺重新设计的波峰焊接产品电路板,对回流焊接炉提供必要温度曲线的能力进行了研究。该电路板是 10"x15.2" ,厚度0.093",安装一个47-mm2 的陶瓷PGA,以及一些典型的标准与密间距的表面贴装元件。该炉子是标准的带有氮气的强制对流型的。
图一显示得到的温度曲线。板上所有的点都在锡膏供应商对峰值温度和回流以上时间的规格内。PGA引脚的温度实际上是两面相同的,尽管有元件的热质量(thermal mass)。小型表面贴装电阻与PGA引脚之间的峰值温度之差只有9°C
初始实施
当工艺在产品电路板实施时,遇到许多的问题。由于焊锡对引脚的分布不均,有时要求焊接点的返工。有些引脚特别少锡,而相邻的引脚又多锡。其它的情况,大的锡“块”保留在引脚端上,因此由于孔内少锡而要求手工的补焊。最后,旧的电路板经常通孔太大,用0.007"厚度的模板不能充满75%的焊锡。没有考虑用更厚的模板,因为使用了0.020"间距的表面贴装元件。 对表面贴装装配过程的观察发现,为通孔元件印刷的锡膏有时会在元件贴装所要求的时间内塌落(slump),使得锡膏沉积跑到一起,或相互“汇合”(图二)。这些电路板的模板具有0.090"或0.092"方形开孔,用来提供尽可能最大的锡膏量。这些开孔只允许0.008"~0.010"的锡膏沉积之间的间隔,因为元件引脚之间的间距为0.100"。
对表面贴装装配过程的观察发现,为通孔元件印刷的锡膏有时会在元件贴装所要求的时间内塌落(slump),使得锡膏沉积跑到一起,或相互“汇合”(图二)。这些电路板的模板具有0.090"或0.092"方形开孔,用来提供尽可能最大的锡膏量。这些开孔只允许0.008"~0.010"的锡膏沉积之间的间隔,因为元件引脚之间的间距为0.100"。
回流焊接后对板的检查证实,放在汇合的锡膏沉积中的连接器几乎总会出现焊锡“抢夺”的效果,造成引脚之间焊锡分布不均匀。如果保持了锡膏沉积之间的分离,引脚的焊锡分配就会一致。
这些观察提出了许多问题。特别是,锡膏沉积(模板网格)之间的分离怎样达到最佳以避免汇合,同时又提供最大的锡量以形成焊接点?我们还不了解阻焊(solder mask)开口的几何形状对引脚之间焊锡分布的影响,如果有的话;需要更好的了解来促进回流期间焊锡从引脚端回到通孔内的运动。最后,在基本问题上还需要数据,多少焊锡、或多少百分比的孔内填充需要用力提供可靠的机械与电气的连接?
试验程序
设计 使用专门的试验板,建立一个试验程序;有些试验也在产品板上进行。使用10个引脚的直线插座(in-line socket),通常用于混合包装,作为将要焊接的元件;设计出试验板。引脚直径是0.019",间距0.100",锡/铅表面涂层。订购的插座引脚长度为0.120"和0.180"。0.120"引脚的基体金属为紫铜(copper),而0.180"引脚为黄铜(brass)。0.120"引脚长度用于所有不涉及拉力试验的应用,假设名义引脚的背部突出对0.062"厚度的板和0.093"的板分别0.058"和0.027"。
使用专门的试验板,建立一个试验程序;有些试验也在产品板上进行。使用10个引脚的直线插座(in-line socket),通常用于混合包装,作为将要焊接的元件;设计出试验板。引脚直径是0.019",间距0.100",锡/铅表面涂层。订购的插座引脚长度为0.120"和0.180"。0.120"引脚的基体金属为紫铜(copper),而0.180"引脚为黄铜(brass)。0.120"引脚长度用于所有不涉及拉力试验的应用,假设名义引脚的背部突出对0.062"厚度的板和0.093"的板分别0.058"和0.027"。 在用于拉力试验的插座上,插座每一端的一个引脚向外弯曲,提供拉力试验夹具所要求的离板高度(standoff)。0.120"长的引脚用于在0.062"厚板上的拉力试验,留下大约0.010"~0.020"的引脚突出。0.180"的引脚主要用于0.093"厚板上的拉力试验,靠外引脚弯曲以提供0.030"~0.040"的突出。焊接之后,每个插座的引脚被分出来用于拉力试验,使用手磨工具将塑料壳从引脚去掉。
在用于拉力试验的插座上,插座每一端的一个引脚向外弯曲,提供拉力试验夹具所要求的离板高度(standoff)。0.120"长的引脚用于在0.062"厚板上的拉力试验,留下大约0.010"~0.020"的引脚突出。0.180"的引脚主要用于0.093"厚板上的拉力试验,靠外引脚弯曲以提供0.030"~0.040"的突出。焊接之后,每个插座的引脚被分出来用于拉力试验,使用手磨工具将塑料壳从引脚去掉。
| 表一、试验板与模板设计 | |
| 板的材料 | FR-4 |
| 厚度 | 0.062", 0.093" |
| 板的表面涂层 | HASL, LPI阻焊层 |
| 通孔直径 | 0.028" |
| 焊盘直径 | 0.050" |
| 阻焊层开口(标准圆形) | 0.058" 直径 |
| 模板开孔 | 0.040",0.050",0.060",0070",0.080", 0.085"和0.090"方形 |
| 阻焊层开口(特殊方形) | 0.072", 0.077", 0.082" |
| 对方形阻焊开口的模板开孔 | 0.080", 0.085", 0.090"分别 |
表一列出板与锡膏模板设计的详细数据。包括了各种尺寸的方形阻焊层开口和标准的圆形开口,来评估阻焊层开口对“抢夺(robbing)”的效果。锡膏模板的厚度为 7-mil。对方形阻焊开口的模板开孔比阻焊开口大0.008",以得到印刷期间良好的“密封(gasketing)”。对标准圆形开口的焊盘开孔覆盖了0.040"~0.090"的范围,对应于0.062"厚板的36%~185%和0.093"板的24%~123%的计算通孔填充量。
试验步骤
试验板的装配
 试验板用标准的Bellcore检定的免洗锡膏印刷。所有锡膏沉积物在印刷之后马上在四倍放大镜下进行视觉检查。将用于拉力试验的插座放在各种提供所希望的通孔填充量的位置。其它插座用来评估由于锡膏汇合所引起的“抢夺”效果。通过在插座安装后马上故意的使插座引脚污染锡膏,来模拟这个效果。使用带氮气的强制对流炉来进行回流焊接,使用锡膏供应商所推荐的回流曲线。
试验板用标准的Bellcore检定的免洗锡膏印刷。所有锡膏沉积物在印刷之后马上在四倍放大镜下进行视觉检查。将用于拉力试验的插座放在各种提供所希望的通孔填充量的位置。其它插座用来评估由于锡膏汇合所引起的“抢夺”效果。通过在插座安装后马上故意的使插座引脚污染锡膏,来模拟这个效果。使用带氮气的强制对流炉来进行回流焊接,使用锡膏供应商所推荐的回流曲线。
视觉评估
完成的板使用7~35倍的立体显微镜来检查。印刷于阻焊层上的锡膏全部流到通孔孔内,因此没有形成锡球。抢夺效果的严重程度与回流前锡膏的汇合程度有关。阻焊层开口的尺寸与形状似乎很少或者没有影响。0.085"或更小的锡膏沉积通常不容易产生抢夺作用,因为很难出现引脚尖的锡膏污染。
孔内焊锡分布是通过有代表性的电路板截面来评估的。除了一些放在0.093"厚度的板中的引脚有24%的焊锡填充量之外,所有回流焊接的引脚(图三)都显示引脚整个周围的焊锡熔湿(wetting)。对一些极其少锡的焊接点,几乎所有的焊锡保持在引脚与通孔的接触点上(图四),并且没有形成引脚周围一整圈。
拉力试验
试验板分开成2"x4.5"的小板,进行拉力试验。一个特制的钩状夹爪安装在测试机的横臂上,然后钩在要测试的引脚肩下。
| 表二、通孔回流焊接拉力试验结果 | |||||||
| PCB厚度 | 充满% (计算值) |
引脚材料 | 热冲击循环 | 平均断裂力(磅) | 标准偏差(磅) | 最小断裂力(磅) | 失效方式 |
| 0.062" | 波峰焊接 | 紫铜 | 0 | 19.5 | 0.6 | 18.3 | 所有针断 |
| 0.062" | 手工焊接 | 紫铜 | 0 | 17.5 | 1.9 | 15.3 | 所有针断 |
| 0.062" | 36 | 紫铜 | 0 | 13.9 | 0.8 | 12.8 | 所有针断 |
| 0.062" | 36 | 紫铜 | 100 | 14.0 | 0.4 | 13.7 | 所有针断 |
| 0.062" | 36 | 紫铜 | 500 | 13.6 | 0.5 | 13.1 | 9针断1针出 |
| 0.062" | 36 | 紫铜 | 1000 | 13.6 | 0.6 | 13.2 | 所有针断 |
| 0.062" | 146 | 紫铜 | 0 | 13.7 | 0.5 | 13.2 | 所有针断 |
| 0.062" | 146 | 紫铜 | 100 | 14.5 | 0.9 | 13.1 | 所有针断 |
| 0.062" | 146 | 紫铜 | 500 | 14.2 | 0.7 | 13.3 | 所有针断 |
| 0.062" | 146 | 紫铜 | 1000 | 14.0 | 0.5 | 13.6 | 所有针断 |
| 0.093" | 波峰焊接 | 黄铜 | 0 | 19.8 | 1.9 | 16.0 | 所有针断 |
| 0.093" | 手工焊接 | 黄铜 | 0 | 20.9 | 1.0 | 19.5 | 9针断1针出 |
| 0.093" | 24 | 黄铜 | 0 | 20.4 | 1.0 | 18.0 | 所有针断 |
| 0.093" | 24 | 黄铜 | 100 | 19.2 | 1.5 | 16.5 | 5针断5针出 |
| 0.093" | 24 | 黄铜 | 500 | 18.5 | 2.4 | 15.5 | 所有针出 |
| 0.093" | 24 | 黄铜 | 1000 | 19.1 | 1.9 | 15.0 | 所有针出 |
| 0.093" | 97 | 黄铜 | 0 | 20.6 | 1.3 | 18.5 | 所有针断 |
| 0.093" | 97 | 黄铜 | 100 | 21.4 | 0.6 | 20.5 | 所有针断 |
| 0.093" | 97 | 黄铜 | 500 | 20.1 | 1.3 | 17.8 | 8针断2针出 |
| 0.093" | 97 | 黄铜 | 1000 | 20.3 | 1.1 | 18.0 | 所有针断 |
表二总结了拉力试验的结果。初始的试验是在手工焊接和波峰焊接的引脚上,形成一个基线。除了一种情况之外,全部的引脚都是以传统的拉力失效形式断裂,没有明显的焊点变形。然后试验回流焊接的引脚。在0.062"厚的板上、低至36%与高至146%通孔填充的焊接点没有发现明显的焊锡变形。都是引脚断裂。手工焊接引脚的断裂强度更高是由于焊锡熔湿到引脚肩部的整个长度。
在有24%~97%通孔填充的0.093"厚的板上的焊点试验产生相同的结果。这些引脚是黄铜,而不是紫铜,大约高出3~6磅的断裂力。
然后板放在空对空(air-to-air)的热冲击室内作加速老化。温度周期的组成是,9分钟85°C,接着11分钟-40°C。温度转变速度是每分钟88°C冷却和每分钟115°C加热。
在100次温度循环之后的拉力试验结果显示很少的变化,除了在0.093"厚的板上只有24%的焊锡填充的引脚之外。这些焊接点的一半是通过把引脚拉出焊锡而失效的,但是最少的断裂力还是16.5磅。焊接点的强度虽着进一步的加速老化而逐渐下降,因此拉出的失效多过引脚断裂。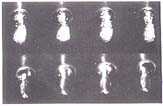
 附加试验
附加试验
在前面的研究中注意到焊锡在引脚端形成“焊锡滴”的趋势2,3。使用0.093"厚度的板对这个效果作进一步的研究。有0.180"焊锡尾的插座放置在印刷与标准焊盘上的0.085"的锡膏方块内。一些插座完全座落,产生大约0.087"的引脚突出。其它插座进行调节以产生一个离板高度,留下大于0.020"~0.030"的引脚突出。图五与图六显示该结果。在较长引脚上的锡膏分散在较大的面积上,不能移上到引脚上以形成与PCB可接受的焊接点。
讨论
焊接点强度
拉力试验结果证实了适当地回流的焊接点,甚至最小的焊锡填充量(通常30~40%),具有很高的机械强度,甚至在加速老化之后。这些结果与在最佳时间与温度条件下形成的通孔焊接点是一致的,通孔焊点具有比表面贴装焊点相对较大的表面积。
加速老化是发现了焊接点强度的一点下降。这个作用在0.093"的伴随特别明显,主要由于用于较厚板的黄铜引脚的较高强度。由于温度疲劳引起的焊接点强度的下降是一个复杂的现象4,5。在任何情况中,焊接点要保持足够的强度,要有超过1000次温带冲击循环的可靠性。
设计上的考虑
在为通孔回流焊接设计一个装配时,必须考虑到许多因素。首先,必须用引脚形状、通孔直径和板的厚度来计算要用锡焊锡填充的体积。然后可以计算出达到通孔填充百分比所需要的锡膏量,估计锡膏内金属的体积含量大约为50%。锡膏可得到的量受到模板厚度、通孔引脚间距和锡膏沉积物之间所要求的最小间隔的限制,锡膏最小间隔将防止装配过程中锡膏塌落而相互接触。
因为许多通孔回流元件不适合机器贴装,通孔必须足够大,有助于手工安装。通孔尺寸的上限是由可得到锡膏的量来决定的。多数装配制造商使用的“现实世界”的兼顾尺寸是,通孔直径比引脚尺寸(直径或对角线)大大约0.010"。应该规定引脚长度,以产生板的底面最小所允许的突出高度。元件最大允许长度将决定于板的厚度、可得到的锡量、和引脚表面涂层,并且必须经常对一个给定的板用试验的方法决定。
最后,注意现有的有关通孔填充的装配工艺标准是基于上锡的工艺过程,在该过程中焊锡供应是无限的,通孔填充不完整通常表示工艺或元件的可能负面影响可靠性的问题6。这个假设不适合于通孔回流焊接工艺,因为每个焊点可得到的焊锡供应是有限的。焊锡填充程度不可以用来指示良好的可焊性。
回流焊点的不同外表,不是拒绝或返工的理由。工艺标准应该谈到对每个引脚的焊锡均匀分布和引脚与通孔的适当的焊锡熔湿。
结论
通孔元件的回流焊接是将这些元件结合到表面贴装工艺的一个有吸引力的工艺方法。通过适当的设计与过程控制,回流焊接点的品质与可靠性将可以与通过传统替代工艺所形成的焊接点相媲美。一个高效的工艺过程将要求对板与元件的仔细开发的设计指南,工艺标准必须与工艺特征相协调。
Acknowledgements
The authors would like to acknowledge the assistance of Jim Kinser and Jim Jones with assembly of the test boards; Robert Schlak with test setup; Dick Max with data collection; Weifan Lin with cross sections; and Don Evans with preparation of the photographs.
- References
- Industry Joint Standard, "Requirements for Soldered and Electronic Assemblies," J-STD-001B, October 1996, pp. 17-18.
- Barthel, B. (August 1994). Through hole connector soldering with solder paste reflow. Surface Mount International Conference Proceedings.
- Gervascio, T. (August 1994). Developing the paste-in-hole process. Surface Mount International Conference Proceedings.
- Hwang, J.S. (1996). Modern solder technology for competitive electronics manufacturing. McGraw-Hill.
- Yost, F.G. Hosking, F.M. and Frear, D.R. (1993). The mechanics of solder alloy wetting and spreading. Van Nostrand Reinhold.
- Devaney, J. and Hutchins, C.L. (1997, July). Simplifying your manufacturing with a paste-insert-reflow process. SMT.
R. Glenn Robertson and Nathalie Nguyen, are process engineers woth Alcatel U.S.A., Richardson, TX; e-mail: glenn_robertson@aud.alcatel.com.