�ڻ���֮���ڴ�ģ���������������ָ�����ܳ��ֽ�������Ⱦ������ζ�Ų�Ʒ��Ʒ�ʺͿɿ�������������������⡣
����ֻ�DZ�����Ⱦ��һ�֣��������Ͱ���ˮ����Ⱦ���������ɽ�����ЩӰ���С�������ں����ɽ���������ʵ������ʪ�ˡ�����ָ���ı��档
��С��ը��
����������ԭ��һ���ǻ�������ʱ�ȵĻ��ۻ��ĺ��������Ե�������������磬ͨ���۲���̣��Ա�֤����˿ӡʱ��������ȣ�����������Լ��ٻ�������
�κη��������ʹ���������ܳ����ڽ���ָ�ϣ����ڻ�������ʱ�Դ��ڣ������Բ���������������
- ��˿ӡ�ڼ�û�в���ģ�����(ģ����)
- ��ӡ���ʵ�������
- ˿ӡ�ڼ䲻С�ĵĴ���
- ������Ϻ���Ⱦ���й���ij���
- ���������б��(����ÿ��4�� C)
�ں����ԭ���У��������ļ����������������ۻ����ӵ��е�С��ը����ʹ������������ڻ���ǻ�ڿ����ҷɣ��ɽ���PCB�ϣ���Ⱦ�������ġ�����ָ����PCB�����ڼ�ס�����������һ���ģ�����������������ͬ��Ч�������Ƶأ�������ϵ�������ȾҲ��������
������Ӱ��
��Ȼ���ǶԽ������ܶ��������ӿ����к���Ӱ��Ĺ�ע����û�еõ�֤ʵ��������Ȼ�Ǹ����⣬��Ϊ���ķɽ������顱����������������ָƽ����ƻ�����Щ�����Dz���˳�ģ��������Ƚ��Բ�ر�����������֮��
��һ�����������������ķ������������ģ��˿ӡ���̡������������Dz���������ԭ��Ļ�����ôͨ�����õ��豸�Ĺ������������õ����ƣ������ʵ���˿ӡ���趨�Ͳ���Ա��ѵ�����ԭ���������ô�������������档
ˮӡ��Ⱦ�������ԭ��δ��ȫ���⣬��Ȼ�����漰�����Դ����Ϊ�Ѿ���ʾ���ġ�δ�ӹ��ġ�������ĺ�û�м�Ԫ���İ壬�ڻ�����Ҳ�����ˮӡ��Ⱦ���������а����������ԭ��PCB���������¯�е���������������ķɽ�����ϴ��IJ����͵��Ƚ�ı�ɫ�ȡ�
ˮӡ��Ⱦ�������ڷ��֣�������������ӿ��ƺ�����Ӱ�졣��ʵ���ڴ�ģ���ʹ���߲����������������Ⱦ����������Ϊ��ı�ɫ��
�������ɽ���һ������Ϊ��������ˮ���ڻ���¯�б�ɿ����ҷɣ���ɢ�������������ϣ���������ָ��������������ͼ˵���������ɽ����ܼ��ŷ����ۺͺϲ�����(˿ӡ�ڼ������ٴ���Ϊ��Ӱ�죬���ɿ���)��
- �ܼ��ŷ���������Ϊ������������ʹ�õ��ܼ������ڻ���ʱ���������ʹ�ù����¶ȣ��ܼ��ᡰ���С�������(���������ȹ��ϵ�ˮ)���ѹ���������У����ɢ�䵽���ϣ���Ϊ�������ɽ���
Ϊ��֤ʵ��������ۣ�ʹ���Ȱ��������е��������飬�������ԡ�ʹ�õ��¶��趨��ֱ�Ϊ190�� C��200�� C��220�� C����״��������(����������ĩ)���κ�����¶������ַɽ������ǣ�����(���з�ĩ��������)�ں����ۻ��ͺ����ڼ�ʼ�ն��зɽ�����һ�ͱ����ǽ����
��һ���ܼ�����ģ������
|
�������� |
���� |
��� |
|
����������(��ĩ)ӡ��ͭ�������������趨Ϊ190�� C��200�� C��220�� C���Ȱ��� |
����������B ����������D |
��������û�����Ե��������ɽ����ڶ��ν������ |
|
������ӡ��ͭ�������������趨Ϊ190�� C��200�� C��220�� C���Ȱ��ϻ��� |
|
���ֽ������������Կ����������ɽ������������ϸߵIJ����ɽ����ܽ��٣�������˵���ڶ��ν������ |
|
������A��Kester244��������B��92��������C��92J��������D��51SC��������E��73D��������F��75 | ||
�������ӽ��������е��������ɽ�ģ������
|
�������� |
���� |
��� |
|
����(�з�ĩ)ӡ��ͭ�������������趨Ϊ190�� C��200�� C��220�� C���Ȱ��� |
�� |
|
|
������(����)ģ��--����ӡ��ͭ�����������趨��ͬ���¶��Ȱ���Ԥ�Ȳ�ͬ��ʱ�䣬���·�Χ150�� C~170�� C��ʱ��1~4���ӡ�����Ȼ��ת���ڶ����Ȱ��ϣ���220�� C���������۲��������ɽ��� |
|
|
|
Sn62�������Sn63������Ƚϣ����Ƿ�Sn62�����Ľ���ٶȻ���ٷɽ� |
|
|
|
������A��Kester244��������B��92��������C��92J��������D��51SC��������E��73D��������F��75 | ||
�����ƶϣ������������������ɽ�����ô����������������ʱӦ�ÿ��������ǣ����ڷɽ����ں������ʱ�۲쵽�ģ�����Ӧ�ÿ��ҵ�������ԭ��������˵���ܼ��������۲��ܽ����������ɽ���
������ۣ��������ۻ��ͽ��ʱ�ۻ����ϵı��������Dһ���ܴ�������D�ڱ���ס����������ʩ��ѹ�������㹻��ʱ�����ҵ��ų�����һ���۵õ��˶�BGAװ���ں����ն����о���֧�֣����������˱�������������������֮�����ϵ(������������ģ��)����ˣ�������������������ɽ�����ܵ�ԭ��������ʵ�����������ɽ�ģ��˵���˽�ϵ�Ӱ�죬�����������ڻ���ǰ�Ѻ�ɡ�������ˣ���ȫ�ĺ�ɴ��ؼ����˷ɽ�(����)��
���������Խ�����ϵ��������ɽ�ģ���D����о�
|
�¶� |
һ���� |
������ |
������ |
�ķ��� |
|
150oC |
�۲쵽�ɽ� |
1-2�ɽ� |
�ɽ� |
�ɽ� |
|
160oC |
1-2�ɽ� |
�ɽ� |
�ɽ� |
�ɽ� |
|
170oC |
�ɽ� |
�ɽ� |
�ɽ� |
�ɽ� |
|
������B 90% Sn63/Pb37 �Ͻ������� | ||||
��ʪ�ٶ�
��Ϊ���ģ�Ϳ�����ɹ������Ե����˸��ֲ��ϵ���ʪ�ٶȡ���ʪ�ٶ��ܺϽ����͡��¶ȡ�����������ͻ���������Ӱ�졣��ͼһ��˵�����¶ȶ���ʪ�ٶ���Ϸ���Ե�Ӱ�죬�¶�Խ�ߣ��ٶ�Խ�졣
ͼһ��һ�ֺ����䷽�ڲ�ͬ�¶Ȳ��Ե���ʪ�ٶȣ�Ӱ�����ذ����Ͻ����͡��¶ȡ�����������ͻ���������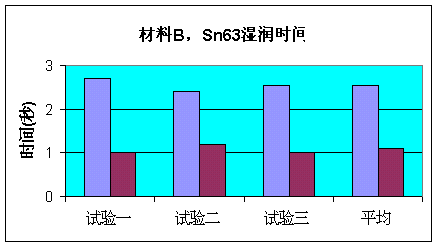
�����ɲ�ʿ�������ģ���ͨ��ȱ�ݻ��Ʒ����Ż��������ߡ���˵����������(��)Ҳ��������ʪ�ٶȡ�SMTר����������.�Ʋ�ʿ�������˵ı���˵�������Ͻ����ʪ�ٶ������ڱȷǹ������Ͽ졣��ˣ�Sn63/Pb37һ���Sn62/Pb36/Ag2��ʪ�ٶȸ��졣Ӱ����ʪ���Ӷ�Ӱ���Ϻ�DZ�ڷɽ��������������ʾ��
���ġ�����������������
|
���� |
���� |
�Էɽ���Ӱ�� |
|
���������� ���Լ� |
��ͬ�Ļ��Լ��ڻ���ʱ��߲�ͬ�̶ȵ�ʪ��ͽ���ٶ� |
���ٵĽ�Ͻ���������������ס�Ŀ����ԣ������������ܼ���������ѹ����������������������Ե��ų��� |
|
�����������ܼ����京�� |
�ܼ����ͺͺ�����Ӱ��Ԥ���ڼ��ɳ̶� |
�����ܼ������������ܼ�ס���������ҵ��ų� |
|
�Ͻ����� |
�Ͻ�Ӱ������ڼ��ʪ��ͽ���ٶ� |
���ٵĽ�Ͻ���������������ס�Ŀ����ԣ������������ܼ���������ѹ����������������������Ե��ų��� |
|
�������� |
����(��)�������ӻ����ڼ��ʪ��ͽ���ٶ� |
���ٵĽ�Ͻ���������������ס�Ŀ����ԣ������������ܼ���������ѹ����������������������Ե��ų��� |
|
�����ۻ��¶� |
���ߵ��ۻ��¶����ӻ����ڼ��ʪ��ͽ���ٶ� |
���ٵĽ�Ͻ���������������ס�Ŀ����ԣ������������ܼ���������ѹ����������������������Ե��ų��� |
�����Ľ������
Ԥ������ֹ����������һ�����������ڽ���ָ��Ϳ��һ��ɲ������躸�㣬��˿ӡ�����Ϳ�������õ������������û��ӡ֤�����ܳɱ��ߣ���Ϊǣ���ֹ���ҵ��Ϳ�����ѡ���������������ѣ��ж�������ˮ��ҵ�������ѡ���ڽ���ָ������ʱ�������������Ҳ��ͬ����ȱ�㡣
��С�����Ż�����������Ļ�ѧ�ɷݣ��ͻ����¶����ߣ�������������͡�Ϊ��֤����һ�㣬�õ��ڴ�ģ�������̵�֧�֣�ͨ�������Բ��Ϻͻ����¶������Ż���Ӱ�죬�����۱�����ϵͳ������ر������Լ����ܼ����Ͻ�ͻ����¶����߶Խ����̶�����ҪӰ�졣��ˣ����������ֽ�����⣬��Щ�������ʵ��������Խ�����������С��
�DZ����ϣ���ۺ�������ϵͳ���ڳɱ��ߡ���������˿ӡ�����̡����ձ仯��ΧС�����������ѣ��������ڱ��о���Χ�����ǣ��ۺ���������ϣ�������ṩһ��������С���Ľ��������������ΪDZ�ڵķɽ��������¶ȼ����ľۺϹ����б���Χ����ˣ�û��Һ�������������������ɽ���
����������һ������С����ڴ�ģ�飬û����װԪ����(�ѷ���Ԫ���ؼ�С������Ӱ�죬��ΪԪ��������������ӽ���ָ���ų�)�������������Ϻ��¶���������������������(����)��������·��ķɽ�ˮƽ��Լÿ100����ϰ���һ���ɽ�������������ʦͨ��20���������۲����еİ壬�����������̶ȡ�
���塢���Բ���
|
���������� |
���� |
���ʪ���ٶ� |
�ܼ����� |
�������� |
�ܼ��ӷ��� |
|
������A |
������������(�ڴ�ģ�������̵�)�еȲ�����RMA�� |
δ֪ |
�� |
�Ƽ����� |
�� |
|
������B |
���������ܡ���˿ӡ�������еȲ��� |
�� |
�� |
��������� |
�� |
|
������C |
���������ܡ���˿ӡ�������еȲ��� |
�� |
�� |
��������� |
�� |
|
������D |
�����ܡ�RMA�ͣ���˿ӡ�������еȲ��� |
�� |
�� |
��������� |
�� |
|
������E |
�Ͳ��������ܼ������������������� |
�� |
�� |
�Ƽ����� |
�� |
|
������F |
���Ͳ��������Ի��� |
�� |
�� |
���� |
�� |
|
������A: Kester244, B: 92, C: 92J, D:51SC, E: 73D, F:75 | |||||
�����о���ʹ�ò�ͬ���Եı����ࡣ�����䲻ͬ��ʪ���ٶȺ��ܼ�������ѡ����Щ���ϡ�Ϊ�����о��еı�����������������ʹ��ͬһ�ֺϽ�Sn63/Pb37������-325/+500Ŀ��
����������
�����¶����ߵ�ѡ�������ڼ�õ���ȷ���������ߺͲ����������߶����������ʹ�ɽ���С������ʹ�õ�������Ҫ�Ļ������߲�ͬ�����䱣���������ԡ�û��ƽ̹�����������������¶�����(ͼ��)��������в��϶�����һЩ��������ԭ�������������������˽�������ˣ����������״û���������о������ڷɽ����Ƶļ��裬������Ե�����û�г�ֺ����������
һ������ǰ;�Ļ���������״����һ��160oC�ĸ��±���(���)�������������ܼ�(ͼ��)�������ܼ�ʧɢ����������ʣ���ճ�ԣ����ٻӷ��ɷݣ���˼��ٷɽ������ǣ�������ɵ�DZ�����������ʪ���Ͳ����ն���ʹ�ö�������(����)������������ʪ�ͼ��ٿն������Էɽ�ȴ��Ч�����������Ҳ��һ�����������ߣ������˹��������ʵ���Ҫ(���ÿ��175oC)��

ͼ���������������ߣ�û�б���ƽ̨�������κκ��������������϶����һЩ����

ͼ������һ�����±��������¶����ߣ��ܼ�����ʧ������µ�������ճ�ԣ���˼��ٽ���
�����¶������о��Ľ����ͼ�ĺͱ������ܽᡣ����ϲ�õķɽ��̶ȣ�������װԪ�����������ϴ����١����Ʊ��������������10-20���ɽ���������װԪ�����ϲ������ɽ�����ˣ�����������D��E��F(����)���ṩ�˿��еĽ������������D�������������������е㣬���շ�Χ��Ϳ��Կ������������ֲ��ϵ��ص㶼����ʪ�ٶ��������ܼ����ͬ������ʾ�����ܼ���������Ч��ɣ���ʪ�ٶȲ����������ɽ��Ĺؼ����ء�

ͼ�ġ�ÿһ�ֲ������ڴ�ģ������һ���ϵķɽ������
Series1: ƽ̹����ɫ��������С������
Series2: ���Ρ������������С������
��������������
|
�������� |
Series1 |
Series2 |
���� |
���� |
|
������A |
0 |
34 |
26��/min |
���� |
|
������A |
0 |
42 |
26��/min |
���� |
|
������B |
12 |
5 |
26��/min |
���� |
|
������B |
4 |
20 |
26��/min |
���� |
|
������B |
0 |
21 |
26��/min |
���� |
|
������B |
0 |
21 |
26��/min |
���� |
|
������B |
0 |
21 |
26��/min |
���� |
|
������B |
0 |
29 |
26��/min |
���� |
|
������C |
2 |
7 |
26��/min |
���� |
|
������C |
0 |
35 |
26��/min |
���� |
|
������D |
0 |
0 |
26��/min |
���� |
|
������D |
0 |
2 |
26��/min |
���� |
|
������D |
0 |
2 |
26��/min |
���� |
|
������D |
0 |
4 |
26��/min |
���� |
|
������E |
0 |
3 |
26��/min |
���� |
|
������E |
0 |
3 |
26��/min |
���� |
|
������F |
2 |
0 |
26��/min |
���� |
|
������F |
1 |
0 |
26��/min |
���� |
|
������A: Kester244; B: 92; C: 92J; D: 51SC; E: 73D; F: 75 | ||||
��������
����������������ڲ�����������ô��������ǶԽ����İ���ͷ�ʱ�ĸ����ж�����Ȼ��ͨ������������䷽�ı仯��������ͨ��Ⱦɫ��ӫ�⻯ѧƷ�������Ҳ�������ʵ��IJ�����˼���Ľ������ҵ��ǣ���Ԥ����ʩһ�����ɱ���ʱ��ʹ�ü����������������ϣ���ġ�
����
��������ȷ���¶����ߣ����Դﵽʵ�������������������ķɽ�������ӷ��ܼ������ߺ���ʪ�ٶ���������ɴﵽ��õ�Ч�����ڸ���������ָ�ͼ���������ṩ��ʱ�Ľ���취����û���ҵ������ĸ���ԭ��
�ο��飺
- Dr. Ning-Cheng Lee, ��Voiding in BGA.�� Indium Corp. of America.
- William Casey, ��Voiding in MicroBGA,�� SMI 1998 Proceedings, MCMS.
Ross B. Berntson, David W. Sbiroli and Jeffery J. Anweilier may be contacted at Indium Corp. of America, 1676 Lincoln Ave., Utica, NY 13503; (315) 863-1000; E-mail: rbb@indium.com, dsbiroli@indium.com and janweiler@indium.com; Web site: www.indium.com.


 ���������� 31011502005504��
���������� 31011502005504��