虽然以产品生命周期短和迅猛的技术改变闻名,电子工业还不得不采用一种工业应用广泛的热空气焊锡均涂(HASL, hot air solder leveling)的替代技术。在过去十年,有无数的论文发表,预言HASL会由有机可焊性保护层(OSP, organic solderability preservatives)、无电镀镍/浸金(ENIG, electroless nickel/immersion gold)或新的金属浸泡技术诸如银与锡所取代。到目前为止,还没有一个预言变成现实。
HASL是在世界范围内主要应用的最终表面处理技术。一个可预计的、知名的涂层,HASL今天使用于亿万计的焊接点上。尽管如此,三个主要动力:成本、技术和无铅材料的需要,推动着电子工业考虑HASL的替代技术。
从成本的观点来看,许多电子元件诸如移动通信和个人计算机正变成任意使用的商品,以成本或更低的价格销售,来保证互连网或电话服务合约。这个策略使得这些商品大量生产和日用品化。因此,必须考虑成本和对环境的长期影响。环境的关注通常集中在潜在的铅泄漏到环境中去。仅管在北美的立法禁止铅的使用还是几年后的事情,但是原设备制造商(OEM, original equipment manufacturer)必须满足欧洲和日本的环境法令,以使其产品作全球销售。这个考虑已经孕育出许多课题,评估在每一个主要的OEM那里消除铅的可选方法。
HASL的替代方法允许无铅印刷电路板(PWB, printed wiring board),也提供平坦的共面性表面,满足增加的技术要求。更密的间距和区域阵列元件已允许增加电子功能性。通常,越高的技术对立着降低成本。可是,大多数替代方法改进高技术装配和长期的可靠性,而还会降低成本。
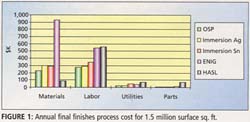 成本节约是整个过程成本的函数,包括过程化学、劳力和企业一般管理费用(图一)。象OSP、浸银和浸锡等替代技术可提供最终表面处理成本的20 ~ 30%的减少。虽然每块板的节约百分比在高层数多层电路板产品上可能低,日用电子的成本节约,随着更大的功能性和铅的消除,将驱使替代方法使用的急剧增加。
成本节约是整个过程成本的函数,包括过程化学、劳力和企业一般管理费用(图一)。象OSP、浸银和浸锡等替代技术可提供最终表面处理成本的20 ~ 30%的减少。虽然每块板的节约百分比在高层数多层电路板产品上可能低,日用电子的成本节约,随着更大的功能性和铅的消除,将驱使替代方法使用的急剧增加。
替代方法的使用将不仅会增加,而且将取代HASL作为最终表面处理的选择。今天替代的问题是选择的数量和已经发表的数据的纯卷积。诸如ENIG、OSP、浸锡和浸银等替代方法都提供无铅、高可焊性、平整、共面的表面,在生产中对第一次通过装配合格率提供重大改进。为了揭开最终表面处理的神秘面纱,这些HASL的替代方法可通过比较每个涂层对装配要求和PWB设计的优点来区分。
装配要求
HASL替代方法对装配过程的作用反映表面的可焊性和它如何与使用的焊接材料相互作用。每一类替代的表面涂层 ― OSP、有机金属的organometallic)(浸锡和银)或金属的(ENIG) ― 具有不同的焊接机制。焊接机制的这种差异影响装配过程的设定和焊接点的可靠性。
OSP是焊接过程中必须去掉的保护性涂层。助焊剂必须直接接触到OSP表面,以渗透和焊接到PWB表面的铜箔上。1
浸洗工艺,如浸银或锡,有机共同沉淀消除最终表面的氧化物。不象OSP,锡和银溶解在焊锡里面,将成为焊接点的一部分,将帮助熔湿速度。锡和银两者都在PWB的铜表面直接形成焊接点。
如果适当地沉淀,在ENIG表面的金是纯净的,由于其可熔于焊锡,所以将提供焊接的最快的熔湿速度。可是,当使用ENIG时,焊接点是在镍障碍层上面形成的,不是直接在PWB的铜表面。
所有三类替代涂层都提供最佳的印刷表面,对所有类型的锡膏都一样。锡膏直接印在表面涂层上面,提供助焊剂直接接触、渗透OSP和熔湿PWB表面。印刷模板对沉积完美的锡膏印刷,形成有效的密封,消除了HASL的印糊和锡桥问题。结果是三种替代涂层都有很高的第一次通过装配合格率,焊锡熔湿方面相差很小。区别在于焊接点的强度和可靠性。几个研究已经证实,使用OSP,直接焊接到铜的表面,提供最好强度的焊接点。2,3当使用区域阵列片状包装的较小焊盘时,焊接点的强度变得重要。
虽然使用上减少,波峰焊接还是今天装配过程的构成整体的一部分。每一种最终表面涂层的焊接机制将影响助焊剂化学成分的选择和波峰焊接工艺的设定。金属的和有机金属的涂层有助于通孔的焊锡熔湿,通常要求很少的助焊剂、较低活性的助焊剂和波峰的较少动荡。免洗材料在生产条件下与OSP相处很好,但要求一些优化来增加助焊剂和/或焊锡渗透到通孔内。通常,这个优化增加助焊剂的使用量,代替特定类型的助焊剂化学成分,或通过更高的动荡或温度来增加焊锡渗透。
全球范围内正在实施取代传统波峰焊接工艺的方法。插入式回流(intrusive reflow)、选择性焊锡喷泉(selective solder fountain)和顺应针(compliant pin)正实际上使用在所有最终表面涂层上。至今为止所完成的工作表明,选择性焊锡喷泉的动荡改善了通孔(through-hole)的可熔湿性。孔中锡膏(paste-in-hole)或侵入式回流将助焊剂和助焊剂载体直接接触PWB的表面,使得通孔的可熔湿性对所有最终表面涂层都是类似的。最后,由于可预见的孔的误差,HASL的替代方法比使用顺应针(compliant pin)的HASL要强。在替代方法中,较厚的浸锡为插件提供最光滑的表面,为顺应针提供最宽的操作窗口。4
装配工业现在正评估无铅焊接替代品。虽然某些合金似乎是特别的OEM的选择,但是,还要选择整个工业所接受的合金。尽管如此,正在测试的所有合金都要求较高的回流温度,并产生较慢的熔湿速度。锡膏供应商已经工程研究了专门的助焊剂化学成分,来改善这些新合金的熔湿。初始的研究表明较高的回流温度不会影响OSP、浸银或浸锡的可焊性或绑接强度。较高的熔化温度明显地帮助OSP的渗透和锡与银表面熔湿,甚至是双面回流。另外的测试正在进行中,以评估熔湿速度的影响和优化对最终表面涂层的特定回流参数。
PWB设计
正如所讨论的,装配过程可以优化,以适合所有的最终表面涂层。PWB的设计将最终决定适于各个应用的最佳的HASL替代方法,但更专门的包装和互连的类型:
- 象按键接触(key contact)、元件屏蔽(component shielding)和插件连接器(edge connector)这样的应用要求在整个设备寿命内的接触电阻低。
- 柔性的电路板通常要求铝的或不锈钢的加强构件或散热器。
- 元件包装和某些PWB要求引线接合(wire bonding)或与直接芯片附着用的导电性胶的兼容性。
- PWB上的高密度互连(HDI, high-density interconnect)几何形状戏剧性地影响使用传统无电镀涂层的合格率。
- 已经看到由于装配在ENIG上的区域阵列包装的绑接强度不够而出现的现场失效(field failure)。
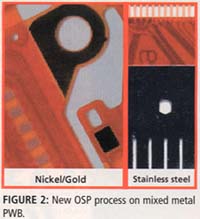 为了满足所有这些要求,电子工业正将注意力集中在三种主要的替代方法上:OSP、浸银和浸锡。这三种涂层的每一种都提供适合特定PWB设计要求的优势。
为了满足所有这些要求,电子工业正将注意力集中在三种主要的替代方法上:OSP、浸银和浸锡。这三种涂层的每一种都提供适合特定PWB设计要求的优势。
OSP是成本最低的替代方法,与多金属表面兼容,提供最高的绑接强度。现在有新的配方,提供较薄的沉淀层,和原先的、消除了多金属表面生锈的一样牢固(图二)。由于耐磨性或电解金沉淀的可焊性,要求多金属涂层,如用于插件连接器或金引线接合(gold wire bonding)的电解镍/金。高成本和焊接点中金的易脆性要求OSP对已焊接的连接作第二次涂层。
 虽然生产已证实按键接触,但ENIG也可以和新的OSP工艺一起使用,如果焊接点的强度对PWB设计是关键的话。这个高接合强度使得OSP成为移动电子和区域阵列包装(area array package)的选择。OSP也显示与使用在倒装芯片应用中的导电性胶的更大的兼容性(图三)。最后,散热器或刚性构件大都可以在最终表面处理之前容易地应用在板列形式。不象OSP,浸或无电镀工艺将镀在不锈钢或铝上面,引起变色。
虽然生产已证实按键接触,但ENIG也可以和新的OSP工艺一起使用,如果焊接点的强度对PWB设计是关键的话。这个高接合强度使得OSP成为移动电子和区域阵列包装(area array package)的选择。OSP也显示与使用在倒装芯片应用中的导电性胶的更大的兼容性(图三)。最后,散热器或刚性构件大都可以在最终表面处理之前容易地应用在板列形式。不象OSP,浸或无电镀工艺将镀在不锈钢或铝上面,引起变色。
和OSP与ENIG比较,浸银还是一个相对较新的技术。可是,在过去六年里,广泛的测试和大量的生产已经证实了这个工艺的可靠性5,6。焊锡的熔湿特性使得这种涂层更适合于一种现存的无铅波峰焊接工艺。这种表面处理方法是大多数应用的潜在替代方法,包括屏蔽、铝引线接合、按键接触和焊接。
如表一所示,这个涂层的接触电阻在经过老化或回流工序之后保持很低。初始的研究显示,接触电阻在与导电聚合物接触300,000次后保持很低,虽然更多工作需要完成。作为一种金属涂层,浸银也可以在低放大或不放大的情况下检查,使得应用者和装配者两个都容易决定其存在。
|
表一、浸银涂层的接触电阻 | |||||
| 系列二,探针半径0.020",接触力10oz。模拟压缩连接器的100%接合。电阻以欧姆测量。 | |||||
|
涂层 |
处理 |
系列号 |
读数#1 |
读数#2 |
读数#3 |
|
电阻 |
电阻 |
电阻 | |||
|
OSP |
BTH处理 |
10370KG2 |
0.500 |
1.25 |
0.500 |
|
OSP |
无环境处理 |
10370KKY |
0.500 |
0.500 |
0.500 |
|
锡 |
BTH处理 |
10370KGM |
0.025 |
0.025 |
0.025 |
|
锡 |
无环境处理 |
10370KHW |
0.025 |
0.025 |
0.025 |
|
银 |
BTH处理 |
10370K9Z |
0.025 |
0.025 |
0.025 |
|
银 |
无环境处理 |
10370K8Y |
0.025 |
0.025 |
0.025 |
|
镍/金 |
无环境处理 |
无 |
0.025 |
0.025 |
0.025 |
|
Sn63/Pb37 |
无环境处理 |
无 |
0.025 |
0.025 |
0.025 |
浸锡已经在PWB和金属表面处理工业使用几十年了。可是,已经开发出新的化学成分,使有机物与锡一起沉淀在铜的表面。这种共同沉淀的有机物消除纤维状结晶(whisker)的增长,这是一个可靠性问题,阻碍铜锡金属间的增长,影响可焊接性能。
这些新的浸锡工艺的结果是,较厚的最终表面涂层(30 ~ 50 millionths百万分之一),提供光滑表面给顺应针插件和在线测试(ICT, in-circuit test)渗透。正在进行中的研究,评估相对ICT探针磨损和几种最终表面涂层的性能。新的浸锡工艺很容易适应无铅装配,并与浸银一样,它们的存在容易检查。
结论
OSP、浸银和浸锡用于混合技术和水溶性与免洗装配技术,都将提供高的第一次通过装配合格率。每个产品的适当应用是通过PWB的设计要求来明确的:
- OSP是成本最低的涂层,为芯片规模(chip-scale)和倒装芯片(flip chip)包装提供最好的焊接强度。新的配方能够处理多金属表面,如镍/金带自动连接(TAB, tape automated bonding)或铝散热器和刚性构件。
- 浸银提供一种可引线接合的(wire bondable)单一的表面涂层,具有对按键接触的和金属对金属屏蔽的低接触电阻。
- 浸锡提供较厚的、均匀金属涂层,改善ICT探针寿命和压入装配针的光滑性。
OSP已经是HASL替代品的市场主流,为应用者提供最宽的处理窗口。作为较新的产品,浸银和锡还必须达到相同的市场渗透,现在,要求应用过程中更多的关注。全球都在作经验积累,以解决工艺问题,使得可以从HASL容易地转换到其它替代方法。
- References
- Stafstrom, E., Wangenroth, K. (1999, May)Addressing future surface finishing needs with OSPs.
- Evans, R., et al. (1998). Implementation of area array, CSPs, BGAs and ultra-fine pitch devices.
- Johnson, R., et al. (1999). Thermal cycle reliability of solder joints to alternate plating finishes.
- Morse, G., Howland, N. (1998). OSP and the pressfit connection.
- Furnanz, J., et al. (September 1999). Manufacturability and reliability evaluation of immersion silver.
- Wenger, G., Furrow, R. (September 1999). Immersion silver surface finish: Usage requirement test results and production experience.
Eric Stafstrom, is product manager of Enthone PWB final finishes with Polyclad Technologies, New Haven, CT; e-mail: estafstrom@enthone.com.


 沪公网安备 31011502005504号
沪公网安备 31011502005504号