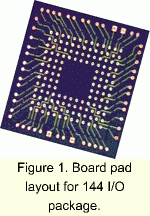 随着电子装配变得越来越小,密间距的微型球栅列阵(microBGA)和片状规模包装(CSP)满足了更小、更快和更高性能的电子产品的要求。这些低成本的包装可在许多产品中找到,如:膝上型电脑、蜂窝电话和其它便携式设备。包装尺寸和锡球间距的减少,伴随PCB上元件密度的增加,带来了新的装配与返工的挑战。如果使用传统的返工工艺而不影响邻近的元件,紧密的元件间隔使得元件的移动和更换更加困难,CSP提供更密的引脚间距,可能引起位置纠正和准确元件贴装的问题,轻重量、低质量的元件恐怕会中心不准和歪斜,因为热风回流会使元件移位。本文描述的工艺是建立在一个自动热风系统上,用来返工一些microBGA和CSP元件。返工元件的可靠性和非返工元件的可靠性将作一比较。
随着电子装配变得越来越小,密间距的微型球栅列阵(microBGA)和片状规模包装(CSP)满足了更小、更快和更高性能的电子产品的要求。这些低成本的包装可在许多产品中找到,如:膝上型电脑、蜂窝电话和其它便携式设备。包装尺寸和锡球间距的减少,伴随PCB上元件密度的增加,带来了新的装配与返工的挑战。如果使用传统的返工工艺而不影响邻近的元件,紧密的元件间隔使得元件的移动和更换更加困难,CSP提供更密的引脚间距,可能引起位置纠正和准确元件贴装的问题,轻重量、低质量的元件恐怕会中心不准和歪斜,因为热风回流会使元件移位。本文描述的工艺是建立在一个自动热风系统上,用来返工一些microBGA和CSP元件。返工元件的可靠性和非返工元件的可靠性将作一比较。
工艺确认
本方案的目的是检验工业中流行的microBGA和CSP的标准SMT装配和返工工艺。最初的CSP装配已在工业中变得越来越流行,但是元件返工的作品却很少发表。由于小型元件尺寸、减少的球间距和其它元件的紧密接近,对板级返工的挑战要求返工工艺的发展和优化。本研究选择了几种元件(表一)。这些元件代表了各种输入/输出(I/O)数量、间距和包装形式。
内存芯片包装通常是低I/O包装,如包装1、2和4。通常这些包装用于双面或共享通路孔的应用。包装3,有144个I/O,典型地用于高性能产品应用。所以CSP都附着有锡/铅(Sn/Pb)共晶焊锡球,其范围是从0.013"到0.020"。所有包装都缝合以允许可靠性测试。
为装配准备了两个测试板设计。一个设计是标准的FR-4 PCB,表面有用于线出口的"dogbone"焊盘设计。第二个设计使用了表层电路(SLC, Surface Laminar Circuit)技术*,和为线出口使用捕捉照相通路孔设计,而不是dogbone设计。板是1 mm厚度。图一所示为典型的144 I/O包装的焊盘形式。
试验程序
该返工工艺是在一台带有定制的偏置底板的热风返工工具**上完成的:
使用BGA喷嘴热风加热 适于小型microBGA和CSP返工的低气流能力 在定制偏置底板上对板底面加热 计算机控制温度曲线 校正的视觉系统 自动真空吸取和元件贴装
接下来的特殊工业流程是典型的用于BGA返工的。用热风喷嘴加热元件到焊锡回流温度,然后拿走。板座上的焊锡使用焊锡真空工具移去,直到座子平坦。然后座上上助焊剂,新的元件对中和贴装,焊锡回流焊接于板上。
要求作出元件移去和重新贴装的温度曲线。曲线参数必须符合锡膏制造商推荐的回流温度和保温时间。返工的每个元件座单独地作曲线,由于板面吸热的不同,内层和相邻元件的不同。以这种方式,将过热或加热不足或焊盘起脱的危险减到最小。一旦得到温度曲线,对将来所有相同位置的返工使用相同的条件。由于一个修正的回流工艺,开发出元件取下和元件回流贴附的分开的工艺步骤。图二所示,是使用返工工具的减少流量能力(50 SCFH)的温度曲线例子。图三所示,是使用正常空气流量设定(90 SCFH)的对较大元件的温度曲线。
对取下元件,工具的偏置底板设定到150°C,以均匀地加热机板,将返工位置的温度斜率减到最小。(大的温度斜率可能引起局部板的翘曲。)板放于框架的对中定位销上,支持高于底板面0.250"。支持块粘贴于板返工座的背面,以加热期间防止翘曲。板被覆盖并加热到135°C温度。
返工工具使用无力移动技术来从板上移去元件。当过程开始,真空吸取管降低来感应元件的高度,然后升到特定的高度进行加热过程。当元件达到回流温度,真空吸嘴降低到预定高度,打开真空,移去元件而不破坏共晶焊锡接点。丢弃取下的元件,加热板上的下一个点。
元件移去后接下来是座子修饰。这个是使用返工工具的自动焊锡清道夫来完成的。板放在偏置底板上,预热到大约130°C。返工座在开始过程前加助焊剂。焊锡清道夫对SLC预热到420°C,对FR-4预热到330°C,检查板的高度,然后一次过横移过焊盘的每一排,当其移动时把焊锡吸上到真空管。反复试验得出对较小元件座的焊锡高于板面0.010",对较大元件座0.012"。使用异丙醇清洁座,检查是否损坏。典型的可避免的观察是焊锡污斑和阻焊的损坏。
元件贴放和回流步骤如下进行。板预热到135°C,使用无麻刷擦过板面来给座加助焊剂。助焊剂起着将元件保持在位和回流前清洁焊盘表面的作用。使用返工工具的分离光学能力来将元件定位在板,完成元件贴装。
元件贴装后,真空吸取管感觉元件高度,向上移到预定高度。这允许吸取管保持与热风喷嘴内面的元件接触,当热风预热步骤开始时保持元件在位置上。跟着预热保温后,吸取管向上移动另外0.015"或0.020",以防止焊锡回流期间元件倒塌。
结果与讨论
为了成功的CSP元件移动和更换,过程调整是需要的。在峰值温度,真空吸取管要降低到元件表面,损坏焊接点和溅锡到板上周围区域。尽管返工工具据说是使用无力移动技术,元件上轻微的压力足以损坏一小部分的共晶焊接点。板也看到去向上翘曲,使情况恶化。为了防止这个,在移去步骤中增加额外的高度,使得真空吸取管在移去时不会压缩焊接点。
自动元件座清理工艺成功地使焊盘上的焊锡变平。这个步骤是关键的,因为焊盘必须平坦以防止贴装时的歪斜。留下的焊锡覆盖层在任何焊盘上典型地小于0.001"高。图四是在元件移去和座子清理后的典型的元件座的一个例子。
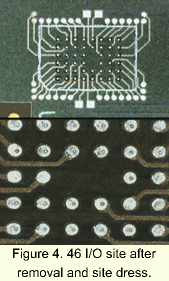
元件贴放和回流是最困难的。在给座子上助焊剂后,贴放元件和回流座子,通常元件会偏斜。在不同情况下,元件锡球在板上焊盘内熔湿不均匀。人们相信,元件太轻,在热风喷嘴内移来移去。这种现象甚至发生在返工工具所允许的低气流量情况。为了防止元件移动,返工工具设定程序,在贴装之后把真空吸取管留在元件顶上,直到通过温度曲线的预热部分。当回流周期开始时,真空管回轻轻缩回,允许元件熔湿焊盘而不损坏焊接点。这个方法使用很好,但有一些缺点。回流期间,元件上的吸取管的高度和重量有时会造成锡桥。真空吸取管似乎也会降低BGA的自对中能力。
面对的另一个问题是板的翘曲。因为板很薄,翘曲是一个很大的关注。使用特殊的支持块来防止翘曲,在每个步骤,板被预热以减少可能引起翘曲的温度差。尽管如此,还有问题。板会在高度读数的压力下向下弓,随后在加热过程中向上翘曲。这意味着,不得不在每一步中增加额外的高度。甚至这还不足够。相同的拆卸参数会破坏拆卸中的元件,并且还不精确到足以拆卸另一块板上的相同位置的元件。
另外,使用的板的上助焊剂技术招徕问题;它是很主观的,一个技术员与另一个技术员差别很大。太多的助焊剂产生一层液体,回流期间CSP元件可能漂移。同时,太少助焊剂意味着当热空气第一次开动时,没有粘性的东西来保持元件在位置上。较近的论文指出,只对BGA本身而不是板的焊接点上助焊剂改进了返工工艺的效率。最终返工焊接点与非返工焊接点是可以比较的,如图五所示。
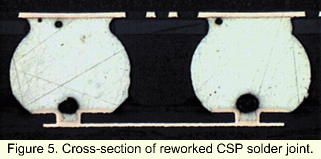
可靠性
装配的测试板进行从-40°C到125°C和从0°C到100°C的加速温度循环(ATC, accelerated temperature cycling)试验。也进行绝缘电阻(IR, Insulation resistance)测试。对任何的包装都没有发现IR失效。包装4有早期ATC失效(100~200个周期,-40°C~125°C),后来发现,该包装的供应商由于可靠性问题没有继续该包装。包装1~3在0°C~100°C的测试中表现良好(大多数情况经受大于1000次循环),而-40°C~125°C的试验有混合的结果。这个温度循环范围可能太进取一点。包装1和2的返工元件的循环寿命比非返工元件稍微低一点,而包装3具有可比较的循环寿命。
结论
MicroBGA和CSP元件可用传统的热风返工工艺进行返工。为得到高效率,返工工艺参数的调节是需要的。因为CSP元件小型,重量轻,要求对热风流量和真空吸管高度的调节以避免元件对不准或元件损坏。使用优化的返工工艺返工的元件,保证了另外的可靠性测试。
This article is adapted from a presentation originally given at APEX 2000.
*Surface Laminate Circuit (SLC) is a trademark of IBM Corp.
** SRT Summit 2000.
*** Senju SP 230C solder paste flux.
ACKNOWLEDGMENTS
The authors would like to thank Nadia Tonsi and supporters of this project. They also thank the APD lab team for building and reworking all test vehicles, particularly Craig Heim for his quality work and Lisa Jimarez for excellent rework support.
REFERENCES 参考书
- Irving Memis, "MicroBGA on Printed Wiring Boards: Recognizing the Need for Surface Laminar Circuit Microvia Wiring Capability," IBM, Endicott, N.Y.
- Alex Chen, et al., "Integrate CSP into Mainstream SMT Assembly Process," Advancing Microelectronics, IMAPS, Vol. 24, No. 6, p. 24-27.
- Reza Ghaffarian, Ph.D., "CSPs Assembly Reliability," Advancing Microelectronics, November/December 1997, p. 18-20.
THOMAS W. DALRYMPLE and CYNTHIA MILKOVICH may be contacted at IBM Microelectronics, Dept. U13G, Bldg. 002-2-B007, 1701 North St., Endicott, NY 13760; (607) 755-2671; Fax: (607) 755-8797; E-mail: twdalrym@us.ibm.com.
(Aaron Ho 08/23/2000)



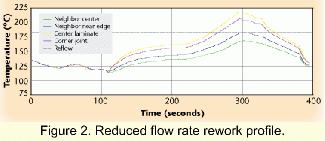
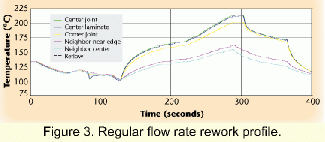
 沪公网安备 31011502005504号
沪公网安备 31011502005504号